1a:Thickness-dose characteristic of standard i-line photoresist (film... | Download Scientific Diagram

Quantitative analysis and modeling of line edge roughness in near-field lithography: toward high pattern quality in nanofabrication

The relation between the photoresist film thickness after multiple dose... | Download Scientific Diagram

Experimental values of and D F vs exposure dose for negative tone epoxy... | Download Scientific Diagram

Process study and the lithographic performance of commercially available silsesquioxane based electron sensitive resist Medusa 82 - ScienceDirect
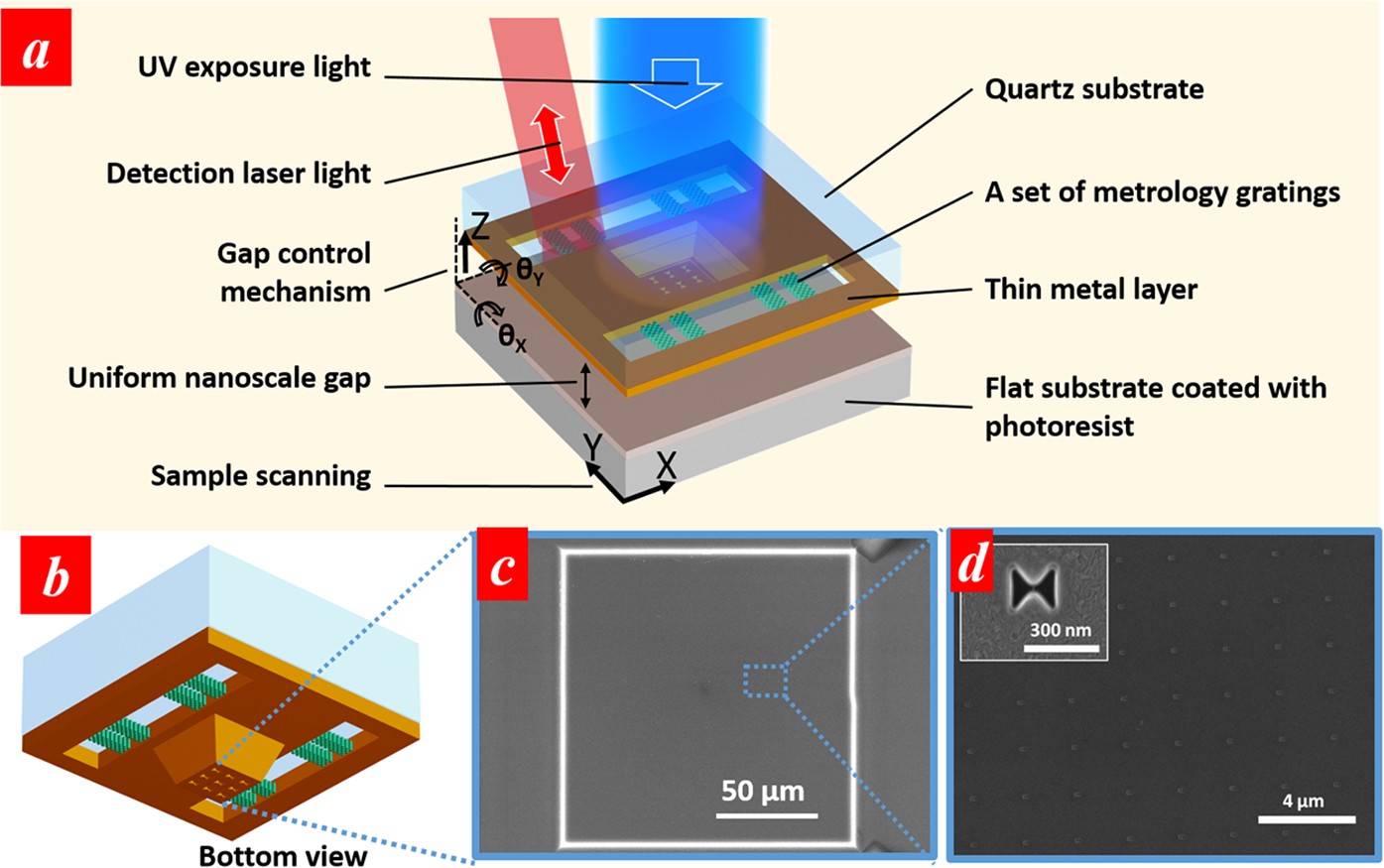
High throughput optical lithography by scanning a massive array of bowtie aperture antennas at near-field | Scientific Reports

a) The relation of exposure dose and spot width (exposure: 1.5, 1.4... | Download Scientific Diagram